|
Etapa I - Studii privind metodele optice de masurare, testare si de analiza materiale si componente fotonice si optoelectronice
|
 |
 |
|
|
 |
REZULTATE
__________________________
|
|
|

-intervalul spectral: 400nm – 1050 nm, domeniul pentru frecventele de lucru: 30 – 9500 cm-1;
-rezolutia spectrala: 0.35cm-1/pixel la laserul de 633 nm cu o retea de difractie cu 1800 gr/mm ;
-rezolutia spatiala a microscopului confocal - diametrul fascicolului laser este sub 1 micrometru, iar performanta axiala confocala mai buna de 2 micrometri.
_______________________________________________________
|
- Metoda elipsometrica pentru caracterizarea straturilor subtiri si structurilor multistrat -
determinari de indici de refractie si grosimi.
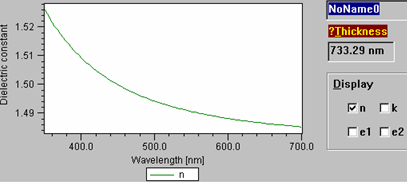
Indicele de refractie functie de lungimea de unda pentru un strat de TiO2 depus pe Si obtinut cu elipsometrul SE 800 / SENTECH
|
_______________________________________________________
- Spectrofotometria de reflexie si transmisie pentru caracterizarea suprafetelor microprelucrate
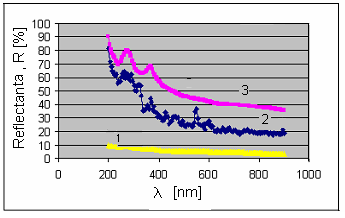
Caracterizarea suprafetei unei plachete de Si in diverse stadii de microprelucrare prin spectrofotometria de reflexie: 1-placheta neprelucrata; 2-stadiul intermediar de prelucrare; 3- stadiul final.
____________________________________________
|
____________________________________________
|